STMicroelectronics - Transfer Molding Simulation to Predict Filling Flaws and Optimize Package Design


Transfer Molding Simulation to Predict Filling Flaws and Optimize Package Design
M. Rovitto/A. Cannavacciuolo - ST Microelectronics - Agrate (Milano)
(Abstract) - Il processo di incapsulamento del microchip mediante iniezione di resina epossidica viene simulato mediante la modellizzazione del flusso nello stampo.
In quest'attività, l'uso della modellazione consente di riprodurre il comportamento di flusso sbilanciato della resina all'interno dello stampo/cavità durante la fase di riempimento che porta alla formazione di vuoti nella fase di impaccamento.
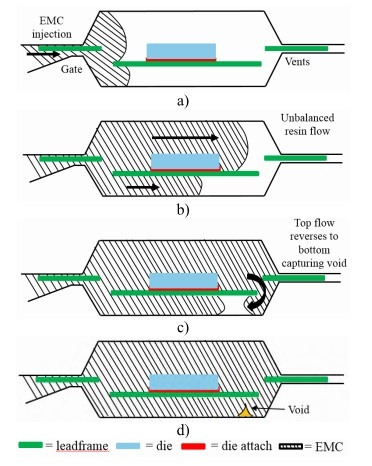
I risultati della simulazione vengono confrontati con i risultati sperimentali, in cui il processo di stampaggio viene interrotto nei punti previsti dalle curve temporali.
Il confronto mostra un ottimo accordo tra risultati numerici e dati sperimentali e dimostra che
efficacia del modello virtuale. Dopo la convalida della modellazione, la metodologia numerica viene applicata in fase di progettazione al fine di ridurre al minimo il rischio di problemi causati in fase di riempimento.
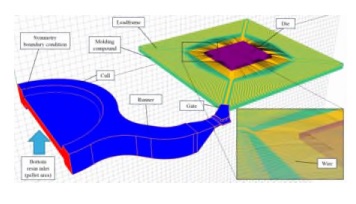
Di conseguenza, le variazioni geometriche mostrano un effetto significativo relativamente alla progressione del fronte fuso in fase riempimento contenedo e/o evitando la generazione di difetti strutturali durante il processo di stampaggio.
--> richiedil'articolo completo